|
Le dépôt d'oxyde de silicium est réalisé
par PECVD à partir du gaz TEOS - Si(OC2H5)4 réagissant
avec de l'oxygène dans un plasma RF d'argon à
basse température.
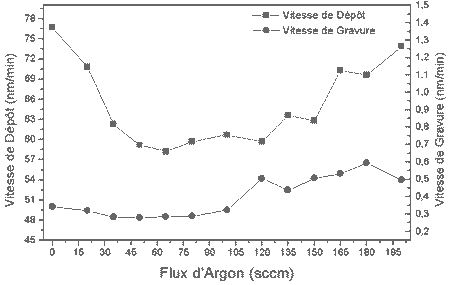
Figure
1 : Evolution de la vitesse de gravure humide et de
la vitesse de dépôt des couches d'oxyde de silicium en fonction
du flux d'argon, avec FTEOS = 7,5 sccm, FO2 = 450 sccm,
P = 1 Torr, T = 375°C et WRF = 400 W [1].
Une
étude de l'influence d'un flux d'argon dans le mélange gazeux
a été réalisée afin d'augmenter la vitesse de décomposition
des molécules de TEOS sans augmenter la densité du plasma.
|
Flux de Ar
|
ILK
(4 MV/cm)
|
EBD
(MV/cm)
|
Qss
(E+12 cm-2)
|
|
150 sccm
|
5.3 pA
|
10.5
|
1.46
|
Table
1 : Courant de fuite (ILK), champ
de claquage (EBD) et densité effective de charges (Qss)
des capacités MOS [2].
La
Figure 1 présente l'évolution de la vitesse de dépôt
et de gravure humide (HF:H2O - DI 1:100) pour les couches
déposées. La Table 1 donne les caractéristiques électriques
de la couche obtenues à partir des courbes J =f(E) (densité
de courant en fonction du champ électrique) des capacités
MOS réalisées avec l'oxyde déposé pour un flux d'argon de
150 sccm.
Les
performances obtenues n'étendent pas en vue des applications
envisages, un nouveau réacteur devenant être plus performant
est en cours de réalisation.
|